
Recubrimiento por pulverización catódica de plasma con magnetrón de alto vacío de doble cabezal
El recubridor por pulverización catódica de magnetrón de doble cabezal VTC-600-2HD es un equipo de recubrimiento de alto vacío desarrollado recientemente por nuestra empresa y se utiliza para preparar películas ferroeléctricas de una o varias capas, películas conductoras, películas de aleación, películas semiconductoras, películas cerámicas, películas dieléctricas, películas ópticas, películas de óxido, películas duras, películas de PTFE, etc. El recubridor por pulverización catódica de magnetrón de doble cabezal VTC-600-2HD está equipado con dos pistolas objetivo y dos fuentes de alimentación, una fuente de alimentación de RF para el recubrimiento por pulverización catódica de materiales no conductores y una fuente de alimentación de CC para el recubrimiento por pulverización catódica de materiales conductores.
- Shenyang Kejing
- Shenyang, China
- 22 días laborables
- 50 juegos
- información
Introducción del producto
El recubridor por pulverización catódica magnetrón de doble cabezal VTC-600-2HD es un sistema de recubrimiento por alto vacío de nuevo desarrollo, diseñado y fabricado por nuestra empresa. Es adecuado para la preparación de películas monocapa o multicapa, como películas ferroeléctricas, conductoras, de aleación, semiconductoras, cerámicas, dieléctricas, ópticas, de óxido, recubrimientos duros y de PTFE (politetrafluoroetileno).
Este sistema está equipado con dos pistolas de pulverización catódica y dos fuentes de alimentación: una de RF para la pulverización catódica de materiales no conductores y otra de CC para la pulverización catódica de materiales conductores. También se puede configurar un objetivo magnético fuerte opcional para la pulverización catódica de materiales ferromagnéticos. En comparación con equipos similares, el VTC-600-2HD presenta un diseño compacto, fácil manejo y amplia compatibilidad con materiales, lo que lo convierte en el instrumento ideal para la preparación de películas delgadas a escala de laboratorio en diversos sistemas de materiales.
Características principales
1. Está equipado con dos pistolas objetivo, una fuente de alimentación de RF se utiliza para el recubrimiento por pulverización catódica de materiales no conductores y una fuente de alimentación de CC se utiliza para el recubrimiento por pulverización catódica de materiales conductores.
2. Se pueden preparar una variedad de películas delgadas con una amplia gama de aplicaciones.
3. Tamaño pequeño y fácil de operar.
TParámetros técnicos
Nombre del producto | Recubrimiento por pulverización catódica con magnetrón de doble cabezal VTC-600-2HD | ||
Modelo de producto | VTC-600-2HD | ||
Condiciones de instalación | 1. Requisitos del banco de trabajo: 2. Suministro de agua: 3. Suministro de gas: 4.Ventilación: 5.Fuente de alimentación: · Monofásica: AC220V 50Hz, 10A. 6. Condiciones ambientales: · Temperatura de funcionamiento: 25℃ ±15℃; humedad: ≤55% RH ±10%. · El ambiente debe estar seco, libre de polvo y libre de gases inflamables o explosivos. | ||
Parámetros principales (Especificación) | Categoría | Especificación | Observaciones |
| Sistema de vacío | Tamaño de la cámara de vacío: D φ300 × H265 mm | - | |
Conjunto de bomba de vacío: • Bomba turbo: Hipace 80 | Original Pfeiffer (Alemania) | ||
| Vacío base: 5,0E-3 Pa (5,0E-5 hPa) | Vacío de base requerido antes de la deposición | ||
Vacío máximo: 5,0E-4 Pa (5,0E-6 hPa) | Afectado por el entorno del sitio y la estanqueidad del sistema | ||
Presión de trabajo: 0,1–5 Pa (0,001–0,05 hPa) | Principalmente argón; se pueden añadir gases reactivos. | ||
| Velocidad de bombeo: • Bomba frontal 1 m³/h; Bomba turbo 67 L/s | El tiempo de aspiración depende de la velocidad de bombeo. | ||
PAGConfiguración de la fuente de alimentación | Tipo y cantidad de energía: CC ×1, RF ×1 | CC: para objetivos metálicos, RF: para objetivos aislantes; (opcionalmente, se puede combinar un objetivo magnético fuerte con el tipo de potencia) | |
Rango de potencia de salida: • CC: 0–500 W • RF: 0–300 W | Poder oModo de salida / Potencia máxima de salida | ||
Impedancia de adaptación: 50 Ω | Garantiza la eficiencia y estabilidad de la transmisión de potencia. | ||
Gas Control | Gas de trabajo: Estándard: Argón (Ar) | Recomendado: Ar, pureza 99.999 | |
Flujo de gas(2 canales) • Canal 1: 1–100 sccm | ELSe pueden personalizar otros tipos de gases protectores si es necesario. | ||
Precisión del medidor de flujo: ±1 % FS | - | ||
| Platina de muestra giratoria | Tamaño del escenario: Ø132 mm | ≈5,2 pulgadas | |
Velocidad de rotación: 1–20 rpm | Mejora la uniformidad de la película. | ||
Temperatura de calentamiento: RT~500 °C | Temperatura de la superficie de la etapa de muestra | ||
Precisión de temperatura: ±1 °C | - | ||
Objetivo de magnetrón | Cantidad objetivo: 2 piezas | Se puede utilizar de forma independiente o simultánea. | |
Tamaño del objetivo: Ø2 pulgadas, espesor 0,1–5 mm | El espesor varía según el material de destino. | ||
Distancia objetivo-sustrato: ajustable entre 85 y 115 mm | Una distancia mayor mejora la uniformidad y reduce ligeramente la velocidad. | ||
Método de enfriamiento: enfriamiento por agua | Circulación de agua para enfriar el objetivo. | ||
Rendimiento de deposición y otros | Uniformidad de la película: ±5 % (para sustrato de Ø100 mm) | Factores clave: distancia objetivo-sustrato optimizada y velocidad de rotación | |
| Rango de espesor de película: 10 nm–10 µm | Un espesor excesivo puede provocar grietas por tensión. | ||
Entrada de potencia máxima: • Unidad principal: 500W; • Fuente de alimentación RF: 1100 W; • Fuente de alimentación de CC: 750 W | La unidad principal, la fuente de alimentación de RF, la fuente de alimentación de CC y el monitor de espesor de película se alimentan de forma independiente. | ||
| Potencia de entrada: • Monofásica CA 220 V 50/60 Hz | |||
Dimensiones de la unidad principal: 600 mm × 750 mm × 900 mm | Altura con tapa abierta: 1050 mm | ||
ELDimensiones generales: 1300 m × 750 mm × 900 mm | IIncluye espacio de control y bomba | ||
| Peso total: 160 kg | Estructura compacta con espacio reducido | ||
Accesorios estándar
| No. | nombre | cantidad | imagen |
| 1 | Sistema de control de fuente de alimentación de CC | 1 juego | - |
| 2 | Sistema de control de fuente de alimentación de RF | 1 juego | - |
| 3 | Sistema de monitoreo de espesor de película | 1 juego | - |
| 4 | Bomba turbo (Alemán, importado o nacional, con mayor velocidad de bombeo)) | 1 unidad | - |
| 5 | Enfriador | 1 unidad | - |
| 6 | Tubo de poliéster PU (Ø6 mm) | 4 metros | - |
Accesorios opcionales
| No. | nombre | Categoría de función | imagen |
| 1 | Diversos materiales objetivo como oro, indio, plata, platino, etc. | Opcional | - |
| 2 | Objetivo magnético fuerte opcional para pulverización catódica de materiales ferromagnéticos | Opcional | - |
| 3 | Dispositivo de deposición giratorio de doble capa | Opcional | 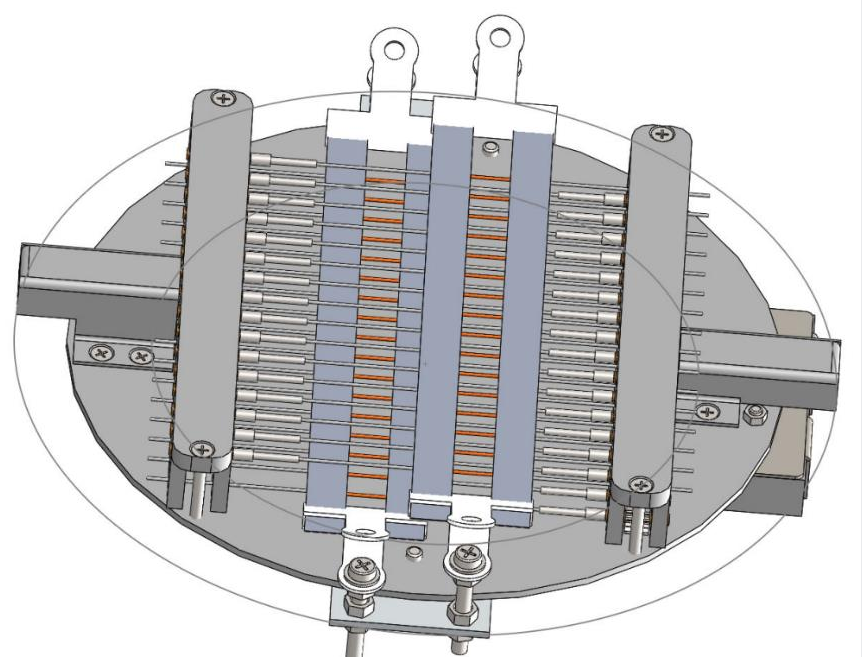 |
Garantía
Garantía limitada de un año con soporte de por vida (sin incluir piezas oxidadas debido a condiciones de almacenamiento inadecuadas)
Logística